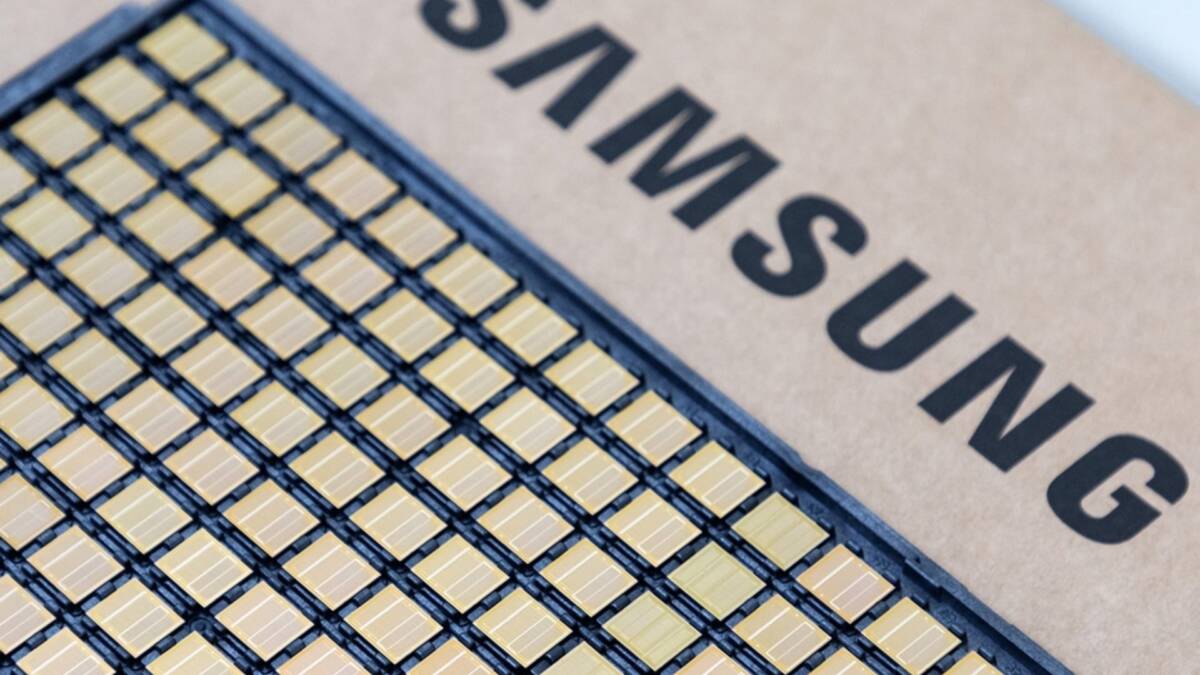
Samsung начал массовое производство HBM4 и уже ускоряет следующую стадию: на фабрике в Чхонане разворачивают линию упаковки с Hybrid Copper Bonding (HCB), чтобы сократить сроки поставок для крупных клиентов, прежде всего Nvidia. Оборудование прибудет в марте, сначала пройдут тесты и верификации, а затем — переход к полноценному производству; компания сдвинула график после просьб со стороны Nvidia.
Hybrid Copper Bonding — это технология склеивания и соединения медных контактов между слоями памяти в стеке HBM. Она улучшает физические и электрические связи между пластинами, снижая сопротивление на переходах и упрощая отвод тепла: по словам технического директора Samsung, HCB может уменьшать тепловое сопротивление до 20% в лабораторных условиях.
Важно помнить, что уменьшение теплового сопротивления в лаборатории — одно; массовое внедрение — совсем другое. На напечатанном конвейере решают не только тепло и латентность сигналов, но и выход годных, стабильность процесса и себестоимость упаковки.
С переходом к четвёртому поколению HBM ключевой рост производительности достигается не столько увеличением тактовой частоты, сколько плотностью и шириной шины: многослойные стеки растут в толщину, а значит — сильнее греются и испытывают электрическую нагрузку. В таких условиях упаковка перестаёт быть вспомогательным этапом и становится фактором, определяющим реальную производительность и надёжность.
Игроки рынка — Micron, SK hynix и Samsung — долго соревновались по чистым спецификациям (скорость, полоса), но сейчас решают, кто сможет быстрее и надёжнее обеспечить сложные упаковочные процессы. Для производителей ускорителей, таких как Nvidia (платформа Rubin) и AMD (MI450), это вопрос графика релизов и наличия памяти на старте производства.
Оборудование прибудет в марте, затем пойдут отладка и проверка качества — типичный цикл перед масштабным запуском. Если HCB подтвердит свои преимущества в промышленном потоке и не приведёт к падению выхода годных, Samsung получит рычаги для сокращения сроков поставок и укрепления позиций у клиентов высокого приоритета. Если же проблемы с надёжностью или себестоимостью появятся на ранних этапах, преимущество вернётся к конкурентам, которые уже отработали альтернативные методы упаковки.
Новый фронт конкуренции в памяти — не столько про скорость передачи в цифрах, сколько про упаковку, термику и производство. На кону — не только технико-экономические преимущества, но и возможность гарантировать поставки для массовых выпусков AI‑ускорителей, где задержки одной линейки могут отложить целый запуск серверного класса.